
在芯片效能及良率提升整合服务中,我们提供完整的软硬件解决方案,从晶圆制造变异检测系统的IP到相应的分析软件,以解决芯片设计公司在设计及制造的难题。有別於传统的晶圆切割道结构测试(Wafer Acceptance Test, WAT)以测量组件的电流与电压关系为主,只能监控组件的静态特性。我们结合效能监控单元 (Performance Monitoring Element) 与芯片制程大数据分析平台 (Process Monitoring Analysis Platform),藉由芯片的串行输出端口,提取封装前、封装后、甚至系统运行中的各项芯片内部的实时表现数据,达成芯片设计优化、制程改善、产品分级,以及效能和寿命分析。

影响芯片性能的变异参数
1

Process Variation (制程差异)
– On Chip Variation (within-die OCV)
– Global Variation (Die-to-Die, Wafer-to-Wafer, Lot-to-Lot)
2
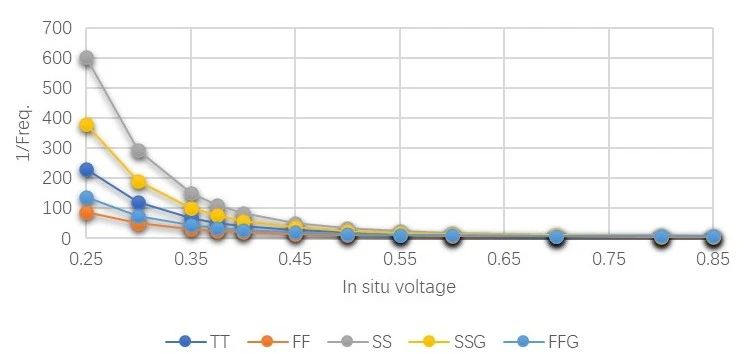
Voltage Variation (电压差异)
– Static & Dynamic IR drop
– Within Chip, Off-Chip
3
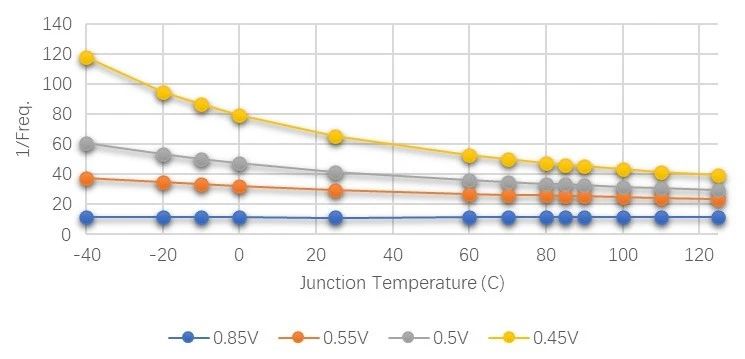
Operating Temperature Variation
(温度差异)
4

Aging Effect (芯片老化)
DTCO方法

新一代的半导体工艺越来越复杂,需要调整的工艺参数也越来越多,由于半导体工艺是提供给不同的客户使用,DTCO 是使用客户的具体设计来检视芯片上 PVT 的变异,提供晶圆厂评估与调整工艺参数的方向,因此 DTCO 可以让相应的电路设计与工艺协同优化,最大化先进半导体节点给芯片带来的工艺优势。
凌烟阁拥有来自台积电及英特尔在 DTCO 方面的专家,是国内目前极少数有能力提供 DTCO 芯片设计服务的公司之一,为业界的领导者。

