随着高性能计算、5G通信、人工智能、生物医疗等领域的发展,业界对高算力、高性能芯片的需求日益提升。为了满足高性能芯片小型化和集成化的需求,先进封装技术也随之不断发展。

凌烟阁封装设计团队提供从封装结构评估和版图设计、电气仿真设计到热管理设计的一整套封装解决方案。

封装结构和版图设计
从封装方案的前期评估与结构选型、芯片Floorplan的评估与优化、到封装layout设计、电热力学协同仿真、最后在业界知名的封测厂完成加工,凌烟阁提供全流程的封装设计服务。
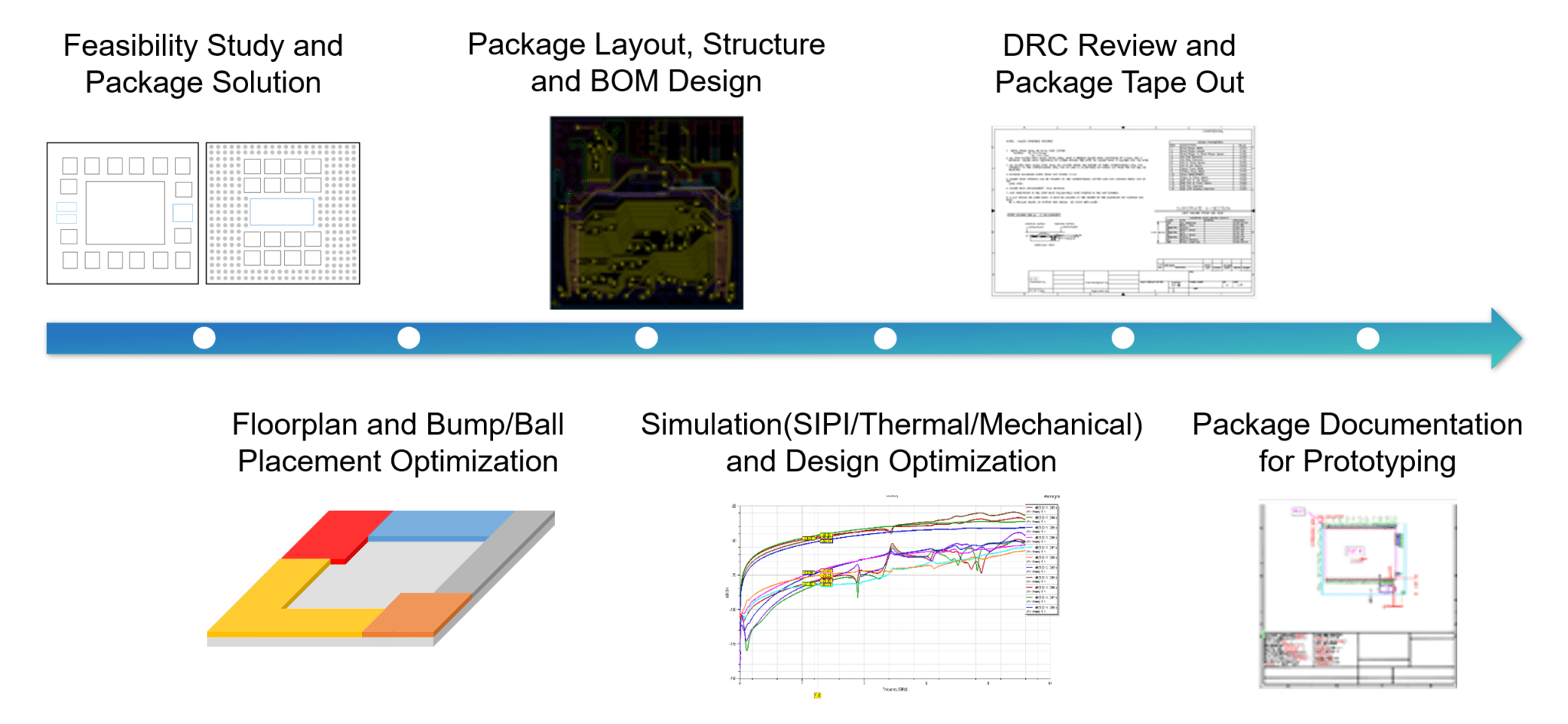
在使用中介层的封装结构中,Die-interposer-substrate三个层级的协同设计非常重要。RDL interposer支持3~5层metal的物理结构,可实现I/O的灵活布局,高密度I/O的扇出,die to die的互连等功能。设计中通过对高速单端、差分信号的layout环境进行有针对性的阻抗设计和隔离保护,实现芯片与芯片、芯片与基板之间的高密度、高效率、低耦合互连。金属层和PI厚度可调,从而更好地满足不同的SIPI需求。

电气仿真
凌烟阁拥有一套完整的SIPI仿真体系和解决方案。从芯片到系统各阶段的评估和联合仿真Die(IBIS模型、CPM模型等)、Package(RLC模型、S参数等)、PCB(Stack up、I/O routing等),输出符合设计规范的眼图、抖动、电源噪声等,实现产品电气性能的稳定。

信号完整性仿真从损耗、串扰、信噪比、眼图及抖动等评估高速信号如Serdes、PCIE及DDR等,保证整个系统的信号传输质量。
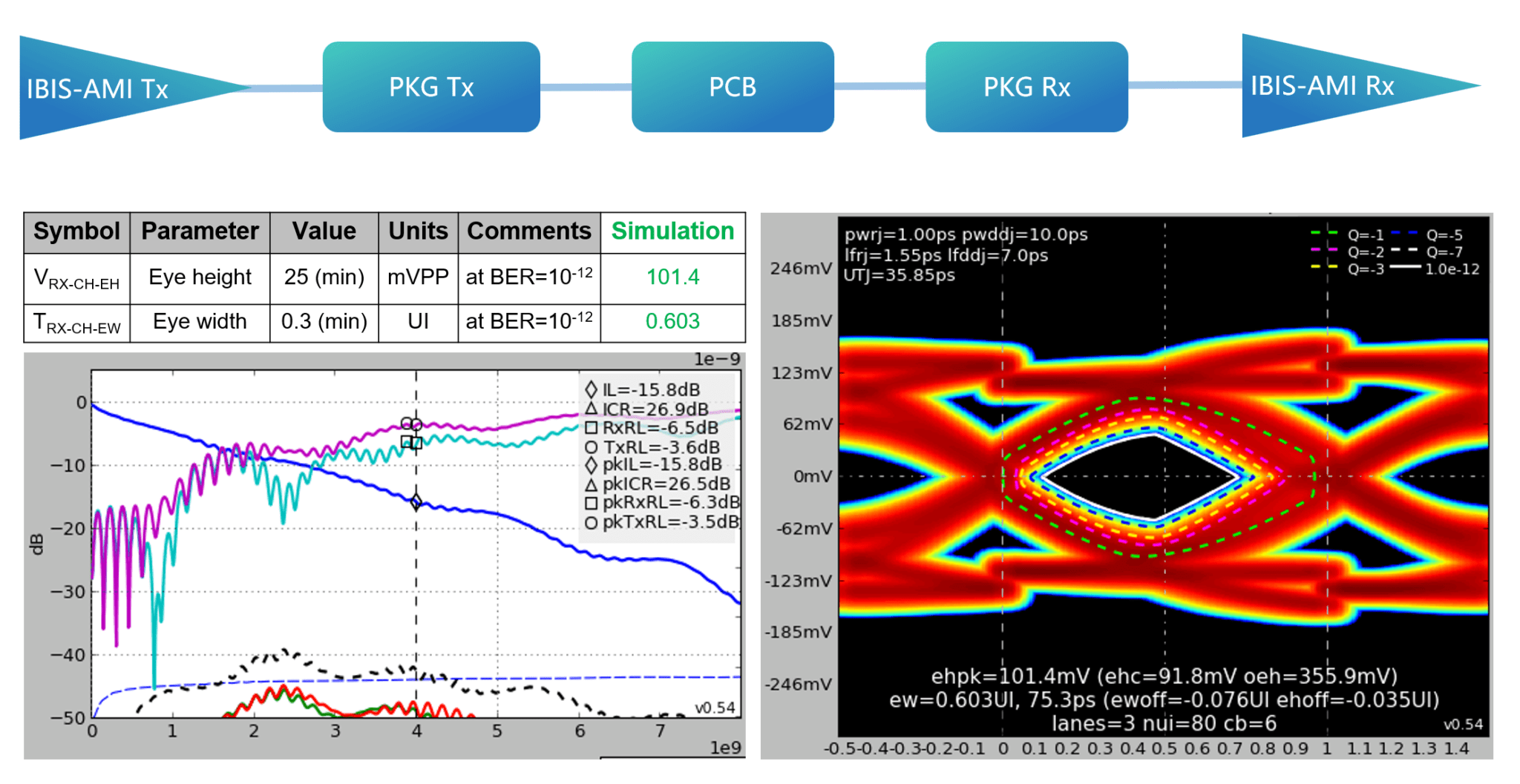
电源系统的稳定一直是整个产品的枢纽,通过PI的仿真从压降、阻抗及噪声等评估标准保证整个电源环路的稳定性。
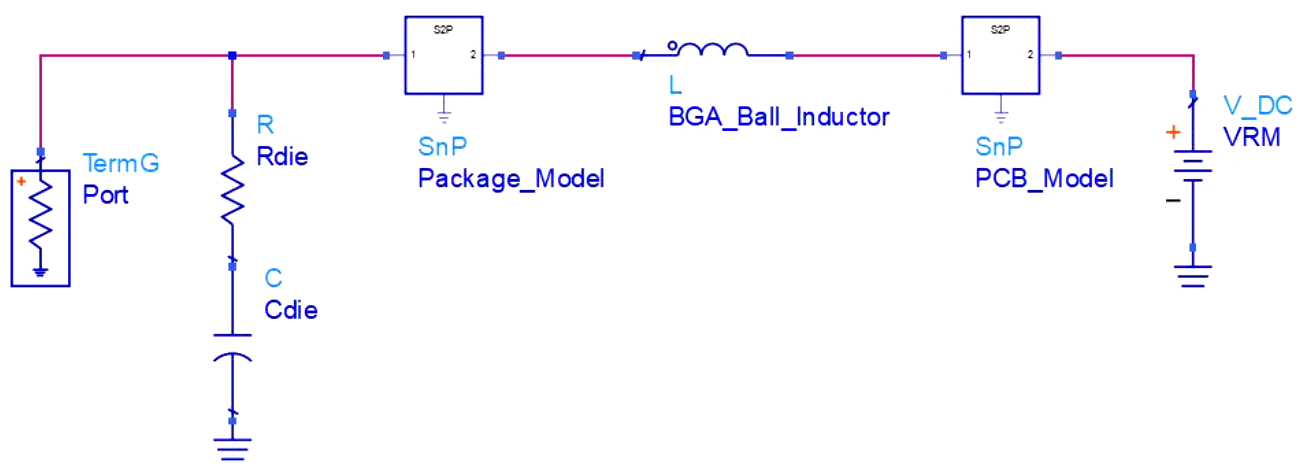

封装热管理
随着封装技术的不断演进,诸如晶圆级封装(WLP)、系统级封装(SiP)、以及2.5D/3D等复杂封装结构的出现,不仅提高了芯片的集成度和性能,还带来了新的散热以及可靠性挑战。

凌烟阁的封装热管理技术通过多维度的模拟和分析,为各种封装结构和热问题提供有效的解决方案:
封装热特性分析:评估封装所有散热路径上的分层热阻,以判断当下主流先进封装的热性能和散热能力,并提供封装等效热阻网络模型和热流分布预测,找出散热瓶颈进一步降低热阻;
热点影响预测:预测芯片封装内部可能出现的高温区域(热点),如Floorplan上的各个功能模块(harden)的温度云图,以及每个模块对应的最高温度,并提供优化方案以避免其对于芯片可靠性的影响;
封装动态温度变化模拟:模拟芯片封装内部的动态温度变化,并提供温度变化曲线以及动画。这样的瞬态仿真对负载波动较大的应用(如高性能计算或图形处理)尤为重要,能准确的反映瞬时温度峰值。
定制化热管理服务:提供板级仿真、终端级仿真、多物理场耦合仿真、先进封装TDP评估、漏电模拟以及封装热应力翘曲模拟等客制化服务,并根据反馈结果在封装选型以及先进封装的结构优化方面给予有效的指导建议。