With the development of high-performance computing, 5G communication, artificial intelligence, biomedicine and other fields, the industry's demand for high computing power and high-performance chips is increasing. In order to meet the needs of miniaturization and integration of high-performance chips, advanced packaging technologies are also evolving.

Lingyange package design team provides a complete package solution from package structure evaluation and layout design, electrical simulation design to thermal management design.

Package structure and layout design
From the preliminary evaluation and structure selection of the package plan, the evaluation and optimization of the chip Floorplan, to the layout design of the package, the electrothermodynamic co-simulation, and finally the completion of the processing in the well-known sealing and testing factory, Lingyange provides the whole process of package design services.
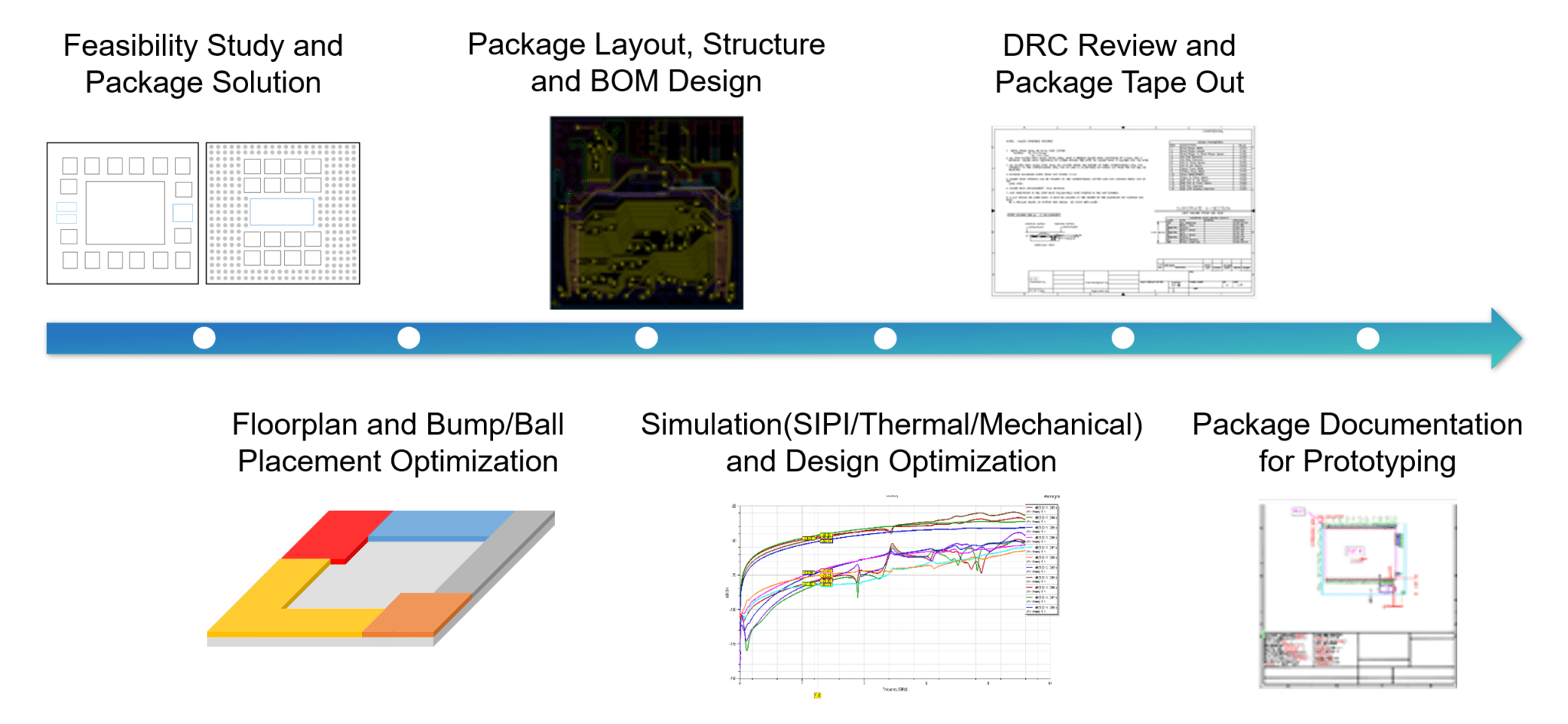
In a package structure using the intermediary layer, the co-design of the Die-interposer-substrate three levels is very important. RDL interposer supports 3 to 5 layers of metal physical structure, can achieve flexible I/O layout, high-density I/O fan-out, die to die interconnection and other functions. The high density, high efficiency and low coupling interconnect between chip and chip, chip and substrate are realized through the targeted impedance design and isolation protection for the layout environment of high-speed single-ended and differential signals. The metal layer and PI thickness are adjustable to better meet different SIPI requirements.

Electrical simulation
Lingyange has a complete set of SIPI simulation system and solutions. Evaluation and co-simulation of Die (IBIS model, CPM model, etc.), Package(RLC model, S parameter, etc.), PCB (Stack up, I/O routing, etc.) from the chip to the system stage, output eye chart, jitter, power noise, etc., in line with the design specifications, to achieve the stability of the electrical performance of the product.

Signal integrity simulation evaluates high-speed signals such as Serdes, PCIE and DDR from loss, crosstalk, signal-to-noise ratio, eye image and jitter to ensure the signal transmission quality of the entire system.
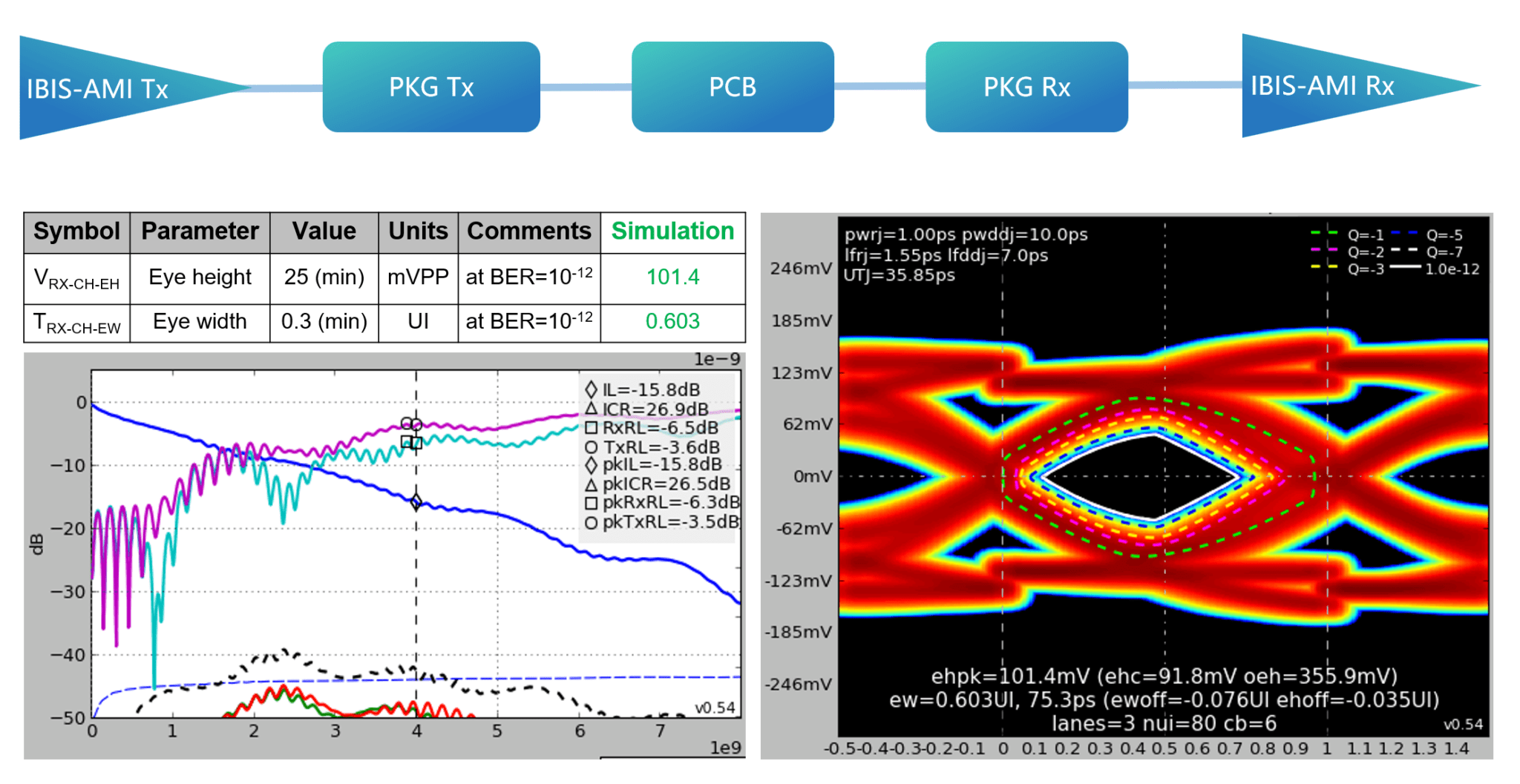
The stability of the power supply system has always been the hub of the entire product, and the stability of the entire power loop is guaranteed through PI simulation from the evaluation criteria such as voltage drop, impedance and noise.
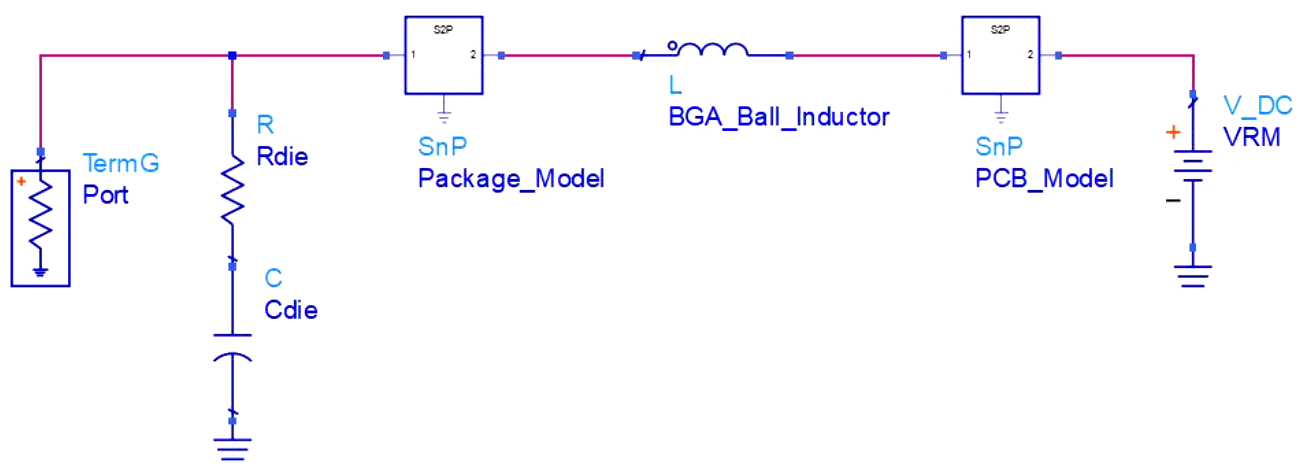

Package Thermal Management
With the continuous evolution of packaging technology, the emergence of complex packaging structures such as wafer-level packaging (WLP), system-level packaging (SiP), and 2.5D/3D not only improves chip integration and performance, but also brings new heat dissipation and reliability challenges.

Lingyange's packaging thermal management technology provides effective solutions for various packaging structures and thermal problems through multi-dimensional simulation and analysis:
Evaluate the layered thermal resistance on all heat dissipation paths of the package to judge the thermal performance and heat dissipation capability of the current mainstream advanced package, and provide the package equivalent thermal resistance network model and heat flow distribution prediction to identify the heat dissipation bottleneck to further reduce the thermal resistance;
Hot spot prediction: Predict the possible hot spots (hot spots) inside the chip package, such as the temperature cloud map of each functional module (harden) on the Floorplan, and the maximum temperature corresponding to each module, and provide optimization plans to avoid its impact on the chip reliability;
Package dynamic temperature change simulation: simulates the dynamic temperature change inside the chip package and provides temperature change curves and animations. Such transient simulation is particularly important for applications with high load fluctuations, such as high performance computing or graphics processing, to accurately reflect instantaneous temperature peaks.
Customized thermal management services: Provide board level simulation, terminal level simulation, multi-physics coupling simulation, advanced package TDP evaluation, leakage simulation and package thermal stress warping simulation and other customized services, and according to the feedback results in package selection and advanced package structure optimization to give effective guidance and suggestions.